新闻中心
News-
 【 微信扫码咨询 】
【 微信扫码咨询 】
- 0512-6603 8633
随着半导体器件特征尺寸持续微缩和三维堆叠结构的广泛应用,传统检测技术面临显著挑战。近红外显微镜(NIR Microscopy)作为一种无损检测技术,凭借其穿透成像特性,在半导体领域获得日益广泛的应用。本文系统阐述近红外显微镜的工作原理与穿透观测能力,并与X射线检测、超声扫描显微镜(SAM)进行综合对比,为半导体行业质量控制和失效分析提供技术参考。
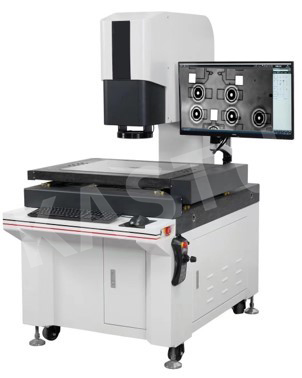
卡斯图MIR400
一、近红外显微镜的穿透观测能力——以卡斯图MIR400为例
1. 工作原理
MIR400采用700-2500nm波段近红外光作为光源,具有以下技术特性:
- 硅材料穿透性:1100nm以上波段可穿透硅基材料(硅晶圆穿透厚度达700μm)
- 分辨率优势:介于光学显微镜与X射线检测之间(0.5-1μm级)
- 安全性:非电离辐射,无样品损伤风险
2. 穿透观测特性
多层结构可视化:
- 清晰呈现芯片内部金属互连层、硅通孔(TSV)及焊点结构
- 支持3D堆叠芯片的逐层非破坏性检测
动态监测能力:
- 实时观测器件工作状态下的内部动态现象
- 捕捉电流分布异常、热点形成等失效过程
三维重构技术:
- 基于焦点堆栈算法实现三维成像
- 无需物理切片即可获取内部结构空间信息
材料鉴别功能:
- 通过特征光谱区分硅、金属、介质等材料
3. 典型应用场景
- 3D IC/TSV结构质量检测
- 倒装芯片焊点完整性评估
- 晶圆级封装(WLP)缺陷筛查
- 短路/断路故障定位
- 器件热分布特性分析
二、三种检测技术的对比分析
1. 技术原理比较
特性 | 近红外显微镜(MIR400) | X-ray检测 | 超声波显微镜(SAM) |
探测原理 | 近红外光反射/透射 | X射线透射 | 高频超声波反射 |
分辨率 | 亚微米级(取决于波长) | 纳米到微米级 | 微米级 |
穿透深度 | 硅材料可达700μm | 无限制 | 取决于材料,通常几毫米 |
成像维度 | 2D/3D | 2D/3D | 2D/3D |
样品准备 | 无需特殊准备 | 无需特殊准备 | 需要耦合介质(通常为水) |
2. 性能参数对比
参数 | 近红外显微镜 | X-ray检测 | 超声波显微镜(SAM) |
空间分辨率 | 0.5-1μm | 0.05-1μm | 5-50μm |
检测速度 | 快(实时观测可能) | 中等(CT扫描耗时) | 慢(逐点扫描) |
材料区分能力 | 中等 | 弱 | 强(基于声阻抗) |
缺陷检测类型 | 表面/近表面缺陷 | 体积缺陷 | 界面缺陷 |
对样品损伤 | 无 | 可能(电离辐射) | 无 |
成本 | 中等 | 高 | 中等到高 |
3. 技术优势与局限
近红外显微镜
✓ 优势:
- 硅基材料专属穿透能力
- 支持动态观测的技术
- 设备集成度高,运维成本低
✕ 局限:
- 对非硅材料穿透能力有限
- 深层缺陷检出率低于X射线
X射线检测
✓ 优势:
- 全材料通用穿透能力
- 纳米级超高分辨率
✕ 局限:
- 设备投资高昂(超千万元级)
- 存在辐射管理要求
超声扫描显微镜
✓ 优势:
- 界面缺陷检测灵敏度高
- 可量化材料机械性能
✕ 局限:
- 需水浸耦合影响部分样品
- 微米级分辨率限制
三、半导体行业应用选型指南
优先选择近红外显微镜的场景
- 硅基器件内部结构快速检测
- 3D IC/TSV工艺开发与质控
- 动态失效机理研究
- 辐射明显样品(如生物芯片)
优先选择X射线的场景
- 2.5D/3D封装全三维结构解析
- 纳米级缺陷准确确表征
- 非硅材料(如化合物半导体)检测
优先选择SAM的场景
- 封装界面分层分析
- 材料弹性模量测量
- 塑封器件内部空洞检测
四、技术发展趋势
1. 多模态融合:NIR+X射线+SAM联用系统开发
2. 分辨率突破:近红外超分辨光学技术应用
3. 智能分析:基于深度学习的缺陷自动分类
4. 系统集成:与电性测试、热成像联机检测
5. 高速成像:毫秒级动态捕捉技术
(更多技术参数请参见本站MIR系列产品技术文档)
结论
近红外显微镜在半导体检测领域建立了应用生态,与X射线、SAM技术形成优势互补。随着异构集成技术的发展,MIR400等近红外系统将通过持续的技术迭代,在半导体制造与封装检测中发挥更核心的作用。建议用户根据实际检测需求(分辨率/穿透深度/材料类型)选择技术方案,必要时采用多技术协同检测策略以实现分析效果。


 微信二维码
微信二维码
 网站二维码
网站二维码